2021年度表面貼裝技術的發展趨勢
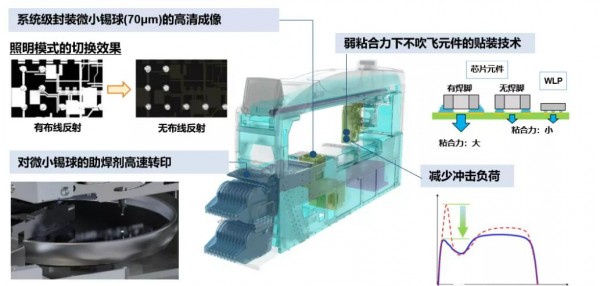
在后疫情時代里,數字化技術的普及應用會進 步將人們的衣食住行等生活信息、氣候變化等環境信息以及企業運營信息編制到 個巨型網絡中進行 元管理,并從中發掘新的價值。我們稱之為“萬物相連時代”。FUJI作為創造時代的親歷者,正在積 發展融入數字孿生解決方案的表面貼裝技術,開創新的機遇。此篇 為各位總結2021年表面貼裝技術的發展趨勢。
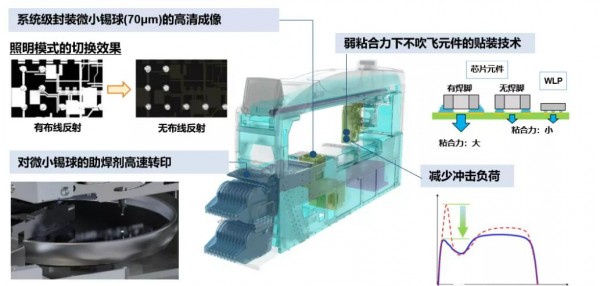
SMT元件的變化趨勢
由于智能手機、智能手表等通信終端的功能與性能不斷提高、5G和IoE的廣泛應用、網絡基礎設施和傳感器設備的增加以及電動汽車的普及,使在單個產品上的電子元件貼裝數量不斷增加。本章將向各位介紹SMT元件的尺寸演變趨勢和半導體封裝的發展趨勢。
根據JEITA電子技術產業協會的2019年度表面貼裝技術規劃圖,我們可以看到2018年多層陶瓷電容器的組成比例達到了0603M和1005M的交叉點,其中0603M的組成比例 高。日后為了提高智能手機的功能并確保電池的搭載空間,將需求更小和更立體的貼裝區域。因此,0402M的構成比例有望繼續增長,預計到2025年達到20%左右, 0201M元件也會在2022年開始面向普及。除了無源元件的小型化,相鄰元件之間的距離也在逐年縮小,預計到2024年將達到50微米左右。這時,當將元件貼裝到間隙窄小的電路板上時,如果吸嘴前端接觸面大于元件的吸取面,則吸嘴前端可能會與相鄰的已貼裝元件發生干涉而導致貼裝不良。回避上述問題的關鍵在于合理的吸嘴設計以及吸嘴的選用,我們日后將進 步提高對貼裝品質的管控,在確保質量的前提下不斷研發更加高速和高精度的貼片機,讓客戶能夠放心地使用FUJI設備。
接下來介紹半導體封裝的發展趨勢。半導體封裝正變得越來越薄型化,貼裝間距也越來越小。比如,大型QFP(Quad Flat Package)逐漸被BGA(Ball Grid Array)取代,小型QFP也逐漸演變為QFN(Quad Flat Non-leaded)、WLP(Wafer Level Package)。另 方面,加工服務器主板時則需要完成對大型重型的BGA的貼裝,目前為止,我們使用模組型高速多功能貼片機NXT的標準規格上限的102mm,特殊規格的150mm能夠應對上述需求。據推測,日后隨著電子產品性能的提高,貼裝元件有多腳化的趨勢,但根據實際應用,元件的尺寸與重量特征也會根據情況發生變化。
以上,我們對SMT元件的變化趨勢以及半導體封裝的貼裝方案進行了闡述,下 期將在此基礎上介紹FUJI如何通過數字孿生技術推進智能工廠的發展。我們下期不見不散!







